目次
概要
第5世代移動通信システム(5G)の商用サービス開始を受け、国内外ではさらに超低遅延や多数同時接続などの機能が強化されたポスト5Gや6Gに関する技術開発が進んでいる。次世代の通信で用いられる電子機器のコネクタや半導体ソケット※1には、これまで以上の薄型・小型化や優れた高周波伝送特性が求められている。しかし従来製法のインサート成形※2では反りが発生するため、厚さ0.8mm程度以下の薄型・小型製品の成型が困難だった。また接続長が長いため、求められる伝送特性を満たす部品が実現できなかった。
このような背景の下、NEDOとアルファー精工、旭電化研究所、シナプスは「戦略的省エネルギー技術革新プログラム」の一環で、東京工業大学および産業技術総合研究所の協力を得て、MEMS※3技術を用いたコネクタやソケットなどの一般電子部品の開発に成功した。これは、母材となる銅張フィルムの上にMEMS技術で凹凸端子を付加して成形する新たな製造方法によるもので、従来は幅2.0mm・厚さ1.0mmだったコネクタが本成果では幅1.2mm・厚さ0.25mmと、格段に薄型・小型になっている。
今回開発された手法では部品の厚さを0.1mm~0.5mm程度と極めて薄く、サイズも従来比3分の1以下にすることができるため、端子接続部の接続長を短くでき、その結果電気インダクタンスが小さくなり伝送特性が向上する。そのため現在開発が進んでいる6G世代の1GHz~30GHzの高周波伝送帯域において、挿入損失が-3dB程度、特性インピーダンスのミスマッチが5Ω以下という伝送特性を満たすとともに、大幅な省エネ化を達成する電子部品の製造が可能となった。また、従来のMEMS技術では利用可能な素材がシリコンのみであることから、用途がセンサーなどに限られていたが、今回開発した手法では金属と樹脂を用いるため、コネクタやソケット、スイッチ、インダクター、ヒートシンク、半導体パッケージ、極細FPC、マイクロモーター部品など多方面の電子部品への応用展開が可能となる。
今回の成果
【1】MEMSコネクタの開発
スマートフォンやノートPC、ゲーム機などに必ず使用される2列型のコネクタをターゲットとし、従来比4分の1の厚さのMEMSコネクタの開発に成功した。伝送特性は従来品に比べ損失が4分の1程度と少なくなっている。本開発コネクタは、従来品に比べ重量で6分の1以下となり、金属や樹脂の使用量が格段と少なくなって、素材の面から省エネ・省資源な製品となっている。
またスマホなどに使用された場合常時コネクタ部でジュール熱が発生するが、本開発品は接触抵抗が既存品に比べ4分の1以下と小さいため、従来比で55%の消費エネルギー削減に貢献することができる。
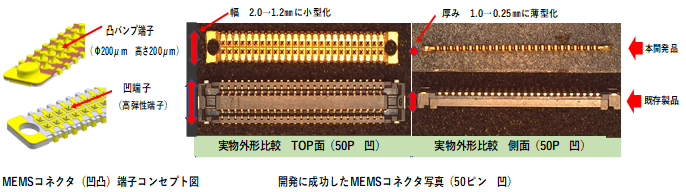
【2】半導体ソケットの開発
スマートフォンやPCに搭載される近年のロジック系半導体パッケージは、図2のように、実装面に多数の半田ボールを有するものがほとんどである。半導体の微細化が進むにつれて、ボールの数は年々増加しボールピッチも小さくなるため、これらを試験する半導体ソケットの製造が、困難で高価となっている。
本開発では1500ピン~2500ピン、ピンピッチ0.3mm~0.5mmのロジック系BGA※4タイプの半導体パッケージの試験と実装をターゲットにした薄型半導体ソケットの開発に成功した。今回開発したソケットでは、ボールピッチを0.3mmにまで小さくしたものに対応することができた。従来はコイルバネを内蔵した接続長の長いプローブピンを格子状に配列した高価なソケットでのみ試験が可能だったが、本開発ではMEMS法により一括でコンタクトデバイスを作製することによって、圧倒的な低コスト化を達成し、かつ高周波対応可能で省エネルギーに貢献するソケットを実現した。
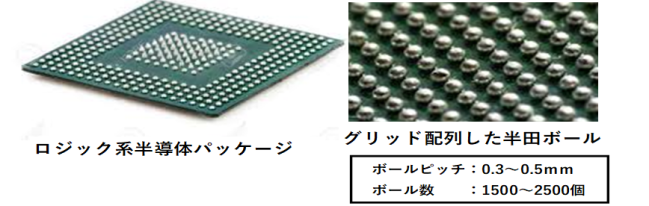
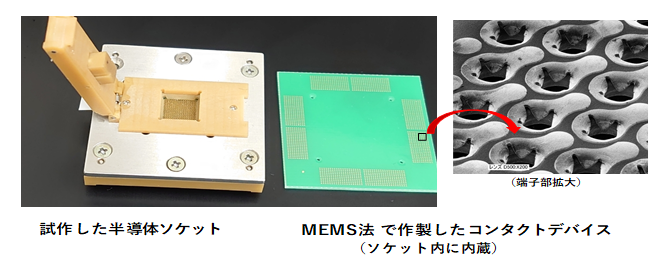
今後の予定
本プログラムでの研究開発終了後においても、引き続き、アルファー精工、旭電化研究所、シナプスの3社は、量産製造や低コスト加工技術、歩留まり改善、さらなる高精度加工技術の開発などに取り組んでいく。これらの技術をスマートフォンなどに使われる微細で高性能な電子部品へ応用展開し、6G世代の通信システムへの進化と省エネ化に貢献することを目指す。
※1 半導体ソケット:メモリやロジック系半導体を試験したり、実装したりするための接続用部品で、ロジック系半導体では数千ピンの半田ボールを有する半導体パッケージを試験するため、高価な試験ソケットが必要となっている。
※2 インサート成形:金型内に挿入した金属部品の周りに樹脂を注入して金属と樹脂を一体化する成形方法で、小型で高精度なコネクタなどの電子部品の製法に利用されている金型プレス法。
※3 MEMS:MEMS(メムス)とは「Micro Electro Mechanical Systems」の略称で、主に半導体のシリコン基板などに、機械要素部品のセンサー・アクチュエーター・電子回路などをひとまとめにしたミクロンレベル構造を持つデバイスを指す。
※4 BGA:BGA(Ball Grid Array)は半田ボールがパッケージの下面に格子状に配列されたパッケージで、スマートフォンやノートPCに搭載されるロジック系半導体は、ほとんどがこのBGAタイプのパッケージが用いられている。